关键词 |
安徽硅通孔填充⼯艺,硅通孔技术,硅通孔填充⼯艺TSV,硅通孔填充⼯艺晶圆 |
面向地区 |
在三维集成中 TSV 技术可分为三种类型:在 CMOS ⼯艺过程之前在硅片 上完成
通孔制作和导电材料填充的是先通孔技术;⽽中通孔,在CMOS制 程之后和后端
制程(BEOL)之前制作通孔。后⼀种后通孔技术是在 CMOS ⼯艺完成后但未
进⾏减薄处理时制作通孔。终技术⽅案的选择要 根据不同的⽣产需求。
北京汐源科技有限公司 汉高授权代理商,专注于电源、新能源、汽车电子、半导体行业胶黏剂产品,公司拥有一批高素质的技术人员,为了客户提供胶黏剂技术一站式解决方案。
公司主要经营品牌包含:汉高、乐泰、汉新、道康宁、洛德、3M等。
公司主要经营产品包含:导热胶、导电胶、灌封胶、密封胶、三防漆、导热垫片、UV胶、芯片保护液、晶圆划片液、晶圆临时键合胶、晶圆清洗液等。
经营设备:晶圆划片机 芯片键合机 点胶机 平行封焊机等。
失效分析技术:Decap开盖,x-ray,快速封装,陶瓷封装,管壳封装,气密性测试,拉力测试,剪切力测试等。
TSV 填充
TSV 填充电镀铜有三种⽅法:
共形电镀,自下⽽上的密封凸点电镀, 和超共形电镀。电镀⽅法是以各种三维
集成应用为基础的。总的来说, TSV 的结构是深度在 10 到 200μm 之前的典型
的圆柱形孔。TSV 的深度 取决于芯片或晶圆键合时的所需厚度,⽽ TSV 纵横
比的⼤小则由介电 膜、阻挡层和种⼦层和填充过程决定的。
STYCAST 2561/CAT 11
乐泰 STYCAST 2651MM/CATALYST 23LV
乐泰 STYCAST 2651MM/CATALYST 9
乐泰 STYCAST 2850FT/CAT 11
乐泰 STYCAST 2850FT/CAT 23 LV
乐泰 STYCAST 2850KT/CATALYST 9
乐泰 STYCAST 2850MT/CATALYST 24LV
乐泰 STYCAST 50500D
乐泰 STYCAST A312
乐泰 STYCAST E1070
乐泰 STYCAST E1847
乐泰 STYCAST EFF15 SYNTACTIC FOAM POWDER
乐泰 STYCAST U2500
LOCTITE ABLESTIK 104
LOCTITE ABLESTIK 16-1
LOCTITE ABLESTIK 2000
LOCTITE ABLESTIK 2000B
LOCTITE ABLESTIK 2000T
LOCTITE ABLESTIK 2025D
LOCTITE ABLESTIK 2025DSI
LOCTITE ABLESTIK 2030SC
LOCTITE ABLESTIK 2035SC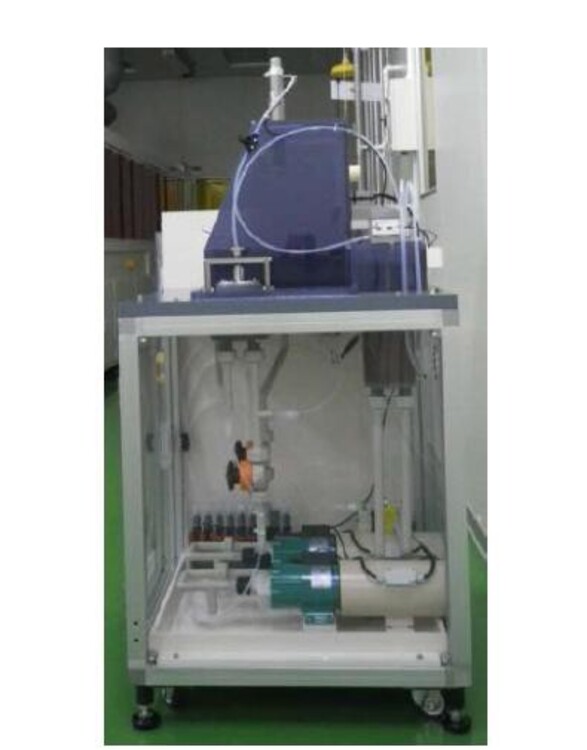
小型喷镀机台
配备有Stir Cup适用于研发以及小批量生产。
特别适合于镀孔,Sn/Ag电镀,Cu pillar等电镀制程。
铜凸块制程即wafer从晶圆加工完成基体电路后,利用涂胶、黄光、电镀及蚀刻制程等制作技术通过在芯片表面制作铜锡凸点,提供了芯片之间、芯片和基板之间的“点连接”,由于避免了传统Wire Bonding 向四周辐射的金属“线连接”,减小了芯片面积(封装效率),此外凸块阵列在芯片表面,引脚密度可以做得很高,便于满足芯片性能提升的需求,并具有较佳抗电迁移和导热能力以及高密度、低阻抗,低寄生电容、低电感,低能耗,低信噪比、低成本等优点。
佛山本地硅通孔填充⼯艺热销信息